مرحله پسین خط
مرحله پسین خط (BEOL) بخش دوم برساخت آیسی است که در آن قطعاتهای مجزا (ترانزیستورها، خازن، مقاومت، و غیره) با سیمکشی بر روی ویفر، لایه فلزپوشش میانهابند میشود. فلزات رایج مس و آلومینیوم هستند.[۱] BEOL بهطور کلی زمانی شروع میشود که اولین لایه فلز روی ویفر تهنشینشده باشد. BEOL شامل اتصالات، لایههای عایقسازی (دیالکتریک)، سطوح فلزی و محلهای اتصالزنی (به انگلیسی: bonding) برای همبندشهای (به انگلیسی: connections) تراشه-به-بسته است.
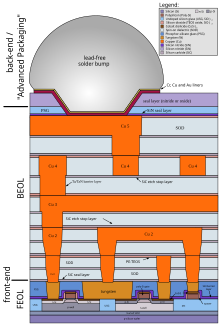

پس از آخرین گام FEOL ، ویفر با ترانزیستورهای مجزاشده (بدون سیم) وجود دارد. در قسمت BEOL اتصالهای مرحله برساخت (پدها)، سیمهای میانهابند، میانراهها (به انگلیسی: vias) و ساختارهای دیالکتریک تشکیل میشود. برای فرایند آیسی مُدرن، بیش از ۱۰ لایه فلزی را میتوان در BEOL اضافه کرد.
مراحل BEOL:
- سیلیسایش (به انگلیسی: Silicidation) ناحیههای سورس و درین و ناحیه پلی سیلیکون
- افزودن دیالکتریک (لایه اول دیالکتریک پیش-فلزی (PMD)-برای عایقکردن فلز از سیلیکون و پلی سیلیکون)، CMP آن را پردازش میکند
- ایجاد حفرههایی در PMD، ایجاد اتصالات در آنها
- اضافهکردن لایه فلزی ۱
- اضافهکردن یک دیالکتریک دوم به نام دیالکتریک بین-فلزی (IMD)
- ایجاد میانراههایی از میان دیالکتریک برای اتصال فلز پایینتر به فلز بالاتر. میانراههای پُرشده توسط فرایند سیویدی فلزی.
- مراحل ۴–۶ را برای بدست آوردن تمام لایههای فلزی تکرار میشود.
- اضافهکردن لایه رویینش (به انگلیسی: passivation) برای محافظت از ریزتراشه
قبل از سال ۱۹۹۸، عملاً همه تراشهها از آلومینیوم برای لایههای میانهابند فلزی استفاده میکردند.[۲]
جستارهای وابسته
ویرایشمنابع
ویرایش- ↑ Karen A. Reinhardt and Werner Kern (2008). Handbook of Silicon Wafer Cleaning Technology (2nd ed.). William Andrew. p. 202. ISBN 978-0-8155-1554-8.
- ↑ "Copper Interconnect Architecture".
خواندن بیشتر
ویرایش- "Chapter 11: Back End Technology". Silicon VLSI Technology: Fundamentals, Practice, and Modeling. Prentice Hall. 2000. pp. 681–786. ISBN 0-13-085037-3.
- "Chapter 7.2.2: CMOS Process Integration: Backend-of-the-line Integration". CMOS: Circuit Design, Layout, and Simulation. Wiley-IEEE. 2010. pp. 199–208 [177–79]. ISBN 978-0-470-88132-3.